

技術・研究開発
Technology/R&D

コーティング技術解説コラム
薄膜を作るには
スパッタリングとは
スパッタリングとは、真空中で不活性ガス(主に、Ar)を導入、ターゲット(プレート状の成膜材料)にマイナスの電圧を印加してグロー放電を発生させ、不活性ガス原子をイオン化し、高速でターゲットの表面にガスイオンを衝突させて激しく叩き、ターゲットを構成する成膜材料の粒子(原子・分子)を激しく弾き出し、勢いよく基材・基板の表面に付着・堆積させ薄膜を形成する技術です。
スパッタリング法では、高融点金属や合金など、真空蒸着法では困難な材料でも、成膜が可能で、広範囲な成膜材料に対応できます。
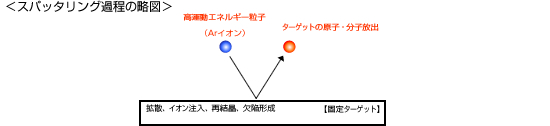
スパッタリングの原理
砂浜に勢いよく小石をぶつけると、砂つぶが勢いよく飛び出します。これが、スパッタ原理のイメージです。

スパッタリング法は、高真空域に一度減圧して、不純物の減少ならびに平均自由行程が大きくなるように気体分子を減少させます。そこへ電圧を印加してグロー放電が発生する真空域(10-1Pa程度)まで不活性ガスを導入します。すると不活性ガスがプラズマ化され、イオン原子がマイナス電位のターゲットへ加速して、激しい夕立のように高運動エネルギーでターゲットの表面に衝突・叩き続け、ターゲット材料の粒子(原子・分子)が勢い良く飛び出し、成膜材料の組成を変えずに、安定して緻密で強い成膜が可能となります。また、スパッタリングに必要な不活性ガスに加えて、反応性ガス(O2,N2,など)を導入することで、酸化物や窒化物の成膜ができる、反応性スパッタリングも可能です。
スパッタリングの成膜材料(代表例)
| 金属 | Cr,Cu,Ti,Ag,Pt,Au,etc. |
|---|---|
| 合金 | Ni-Cr,SUS,Cu-Zn,etc. |
| 酸化物 | ITO,SiO2,TiO2,Nb2O5,ZnO,etc. |
スパッタリングの特徴
- 成膜粒子のエネルギーが大きく付着力が強い
- 成膜が緻密で膜質は強い
- 成膜プロセスが安定していて膜質、膜厚の制御が高精度
- 高融点金属、合金、化合物の成膜が可能
- 反応性ガスの導入で酸化物、窒化物の成膜が可能
スパッタリングの代表的な種類
2極スパッタリング法
2極法は、スパッタリング成膜技術の基本的な原型である。
ターゲットを陰極、薄膜形成する基材・基板を陽極として電圧を加え、ガスイオン原子でターゲット表面を叩き、飛び出したターゲット材料物質の粒子(原子・分子)が基材・基板に堆積する。
2極法の装置構造は簡単であるが、不活性ガスをイオン化するグロー放電を起こすためのガス導入量が多く必要であり、その導入ガスが障害となって成膜速度が遅くなる。
また、イオン化した負イオンなどの二次電子が陽極に照射されて、基材・基板が高温となる問題がある。
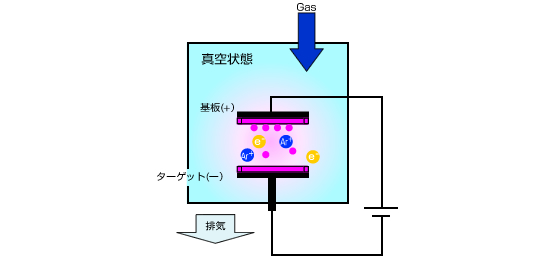
マグネトロンスパッタリング法
マグネトロン法は、2極法スパッタリングの遅い成膜速度を改善するために開発された技術です。ターゲットの裏面に磁石を設置して磁界を発生させ、ガスイオン原子がターゲット表面に衝突し、叩きだされる二次電子をローレンツ力で捕らえてサイクロトロン運動で不活性ガスのイオン化を促進する。負イオンや二次電子を磁界で捕らえられるため、基材・基板温度の上昇が抑えられ、捕えた電子でガスイオン化が促進され、成膜速度を高速にでき、スパッタリングによる成膜技術の主流になっている。しかし磁界を用いるため、ターゲットの浸食がエロージョン領域に留まるため、ターゲットの利用効率が低い問題はある。
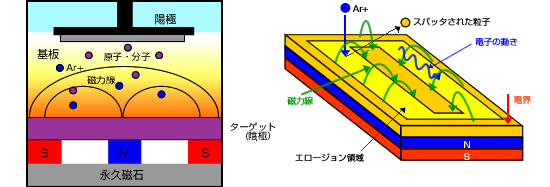
DC(直流)、RF(高周波)、電源のスパッタリング
2極法、マグネトロン法のいずれも、ターゲットに印加する電源にDCとRFを利用する場合がある。
DC(直流)電源の場合、金属以外の絶縁物ターゲットでは、放電が起こらないため、基本的に金属以外の物質はスパッタリング法で成膜することができない。
RF(高周波)電源の場合は、金属をはじめセラミックスやシリカなどの酸化物や金属酸化物、窒化物などでも放電現象の発生が可能で、DCスパッタリング法では成膜ができない物質も成膜が可能です。
デュアル(Dual)マグネトロン方式
2本のターゲットを並べて交互に電圧を印加、ターゲットの表面に生成される絶縁物のチャージアップを防止して、ターゲット表面のクリーニングを行い、スパッタリング法での成膜を安定させる。また反応性スパッタリングでのターゲット表面の化合物生成プロセスを制御する。
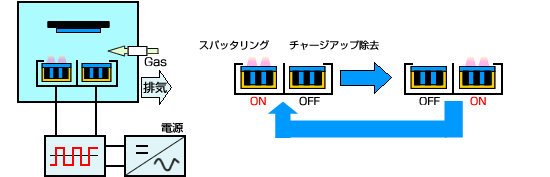
反応性スパッタリング
2極法、マグネトロン法のいずれでも、スパッタリングに必要な不活性化ガスに加えて、反応性ガス(O2,N2,など)を導入混合してスパッタリングを行い、酸化物や窒化物の化合物薄膜を形成する方法である。
反応性スパッタリングは、化合物のターゲットを使用する場合と比較して、薄膜の組成にズレが起きにくく、大電力が投入でき高速の成膜が可能となる。
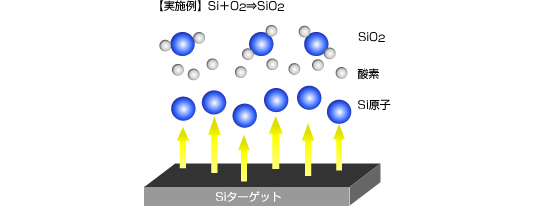
その他、スパッタリングの種類と特徴
対向ターゲット
- 対向するターゲット間に磁場を発生
- Y電子のサイクトロン運動で、ターゲット間にプラズマを閉じ込める
- 基板へのプラズマの影響を受けずに、反応性の高速成膜が可能
- 低圧力での成膜、ターゲットの使用効率も向上
- 磁性体ターゲットも使用可能
- 装置が大型化
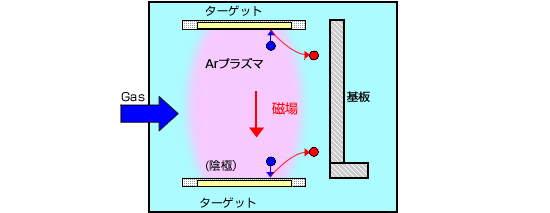
【その他】
- イオンビームスパッタリング
- ECR(Electron Cyclotron Resonance)スパッタリング








